반도체인 Si는 부도체에 가까운 특성을 가집니다. 그래서 전기적 특성을 가지게 하기 위해 붕소(B), 인(P), 비소(As) 같은 불순물을 주입시켜서 n형, p형 반도체로 만드는데, 이렇게 불순물을 주입하는 과정을 도핑공정이라고 합니다.
Doping에는 크게 확산공정(Diffusion)과 이온주입공정(Implantation)이 있습니다.
- 확산공정(Diffusion)
확산공정은 크게 Pre-deposition, activation, drive-in, 후속 열처리과정 순으로 진행됩니다. 물질의 농도 차이로 인한 이동으로 농도의 차이와 온도, 그리고 물질 이동 시간에 의해 영향을 받습니다.
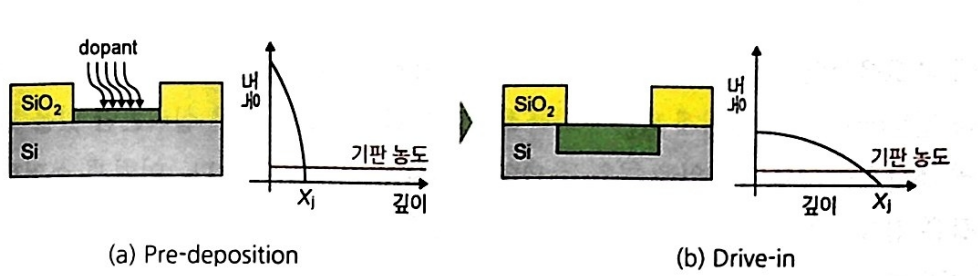
확산을 통한 도핑은 Si 결정에 손상 없이 도핑이 가능하다는 장점이 있지만 도핑 농도를 조절하기 어렵고 불순물이 침투하는 Junction 깊이를 정확히 조절할 수 없다는 단점이 있습니다. 마지막으로 도핑방향이 전방향(등방성)으로 진행되기 때문에 미세패턴에 적합하지 않습니다.
- 이온주입공정(Implantation)
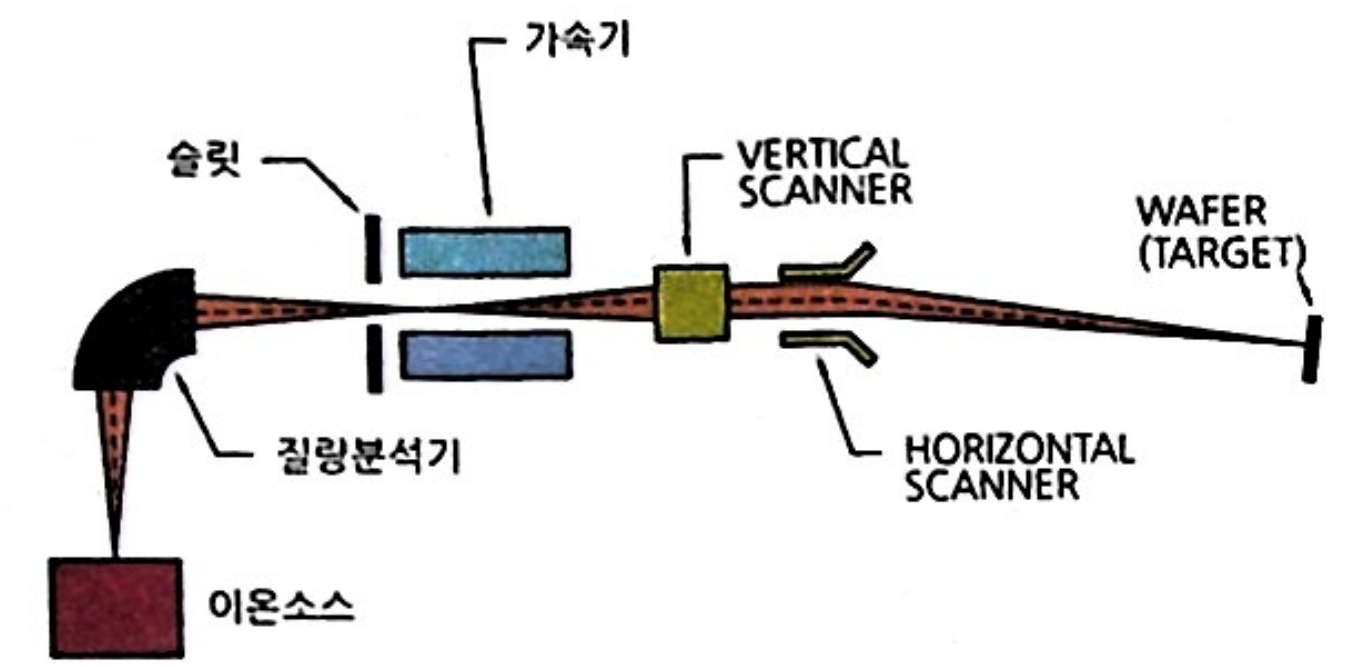
이온주입기는 크게 BF3, PH3, AsH3 등의 가스를 이온화시켜서 원하는 이온소스를 추출하는 이온소스, 자기장을 가해 이온소스를 가속시키는 빔라인(beam line), 기판에 입사시키는 엔드스테이션(End station)으로 이루어져 있습니다. 이온으로는 양이온을 사용하는데 질량분석기의 Analyzer Magnet에서 원하는 이온을 분리해서 사용합니다.

이온주입공정은 이온에 가해진 에너지에 따라 정확한 Juction 깊이를 보입니다.

채널링(Channeling)
단결정 구조에서 입자를 주입시키기 때문에 결정구조의 방향에 따라 이온 Junction 깊이가 달라집니다.

위와 같은 채널링 현상을 방지하기 위해 이온주입공정 시 표면에 산화막을 깔아서 단결정 구조가 노출되지 않게 하거나(a), 기판을 약간 틀어진 상태(Tilting)에서 이온주입을 진행합니다(b). 그리고 실제로 이온을 주입하기 전에 기판 표면에 Si이나 Ge 이온주입을 통해 표면을 비정질상태로 만드는 Pre-Amorphizing Implant, PAI)를 통해 채널링을 방지합니다(c).

Tilting 방법으로 이온주입 공정을 진행할 시 구조에 따라 이온이 입사하지 않는 영역이 생깁니다. 이를 shadow effect라고 하는데 이온주입 양을 4분의 1로 나누고 기판을 0도 90도 180도 270도로 돌려서 이온주입을 진행하면 shadow effect를 완화시킬 수 있습니다.
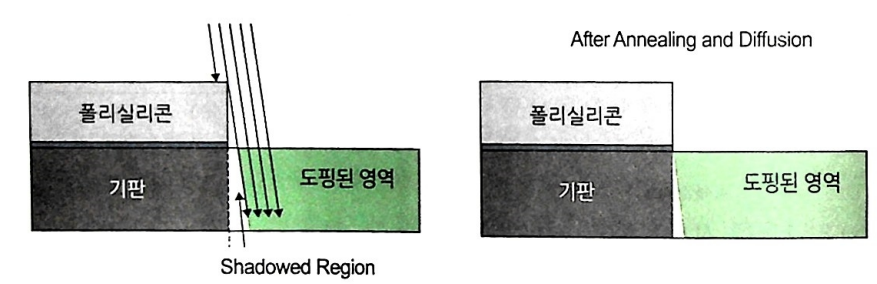
Annealing
이온주입공정은 기판 표면의 격자구조에 손상을 줍니다. 그래서 도핑공정 이후에 Annealing이라는 열처리를 진행합니다.

열처리는 고온(750~900도)에서 30분 이상 진행하게 되는데 이럴 경우 소스/드레인 접합 깊이가 너무 깊어지는 문제가 생깁니다. 그래서 초고온(900~1100도)에서 수초정도의 짧은 시간 동안 열처리를 진행하여 Shallow junction을 만듭니다. 그래서 Furnace 같은 Hot-wall 방식이 아니라 RTP(Rapid Thermal Process) 같은 낱장의 웨이퍼를 처리하는 Cold-wall 장비로 열처리를 진행합니다.
- 확산공정 VS 이온주입공정
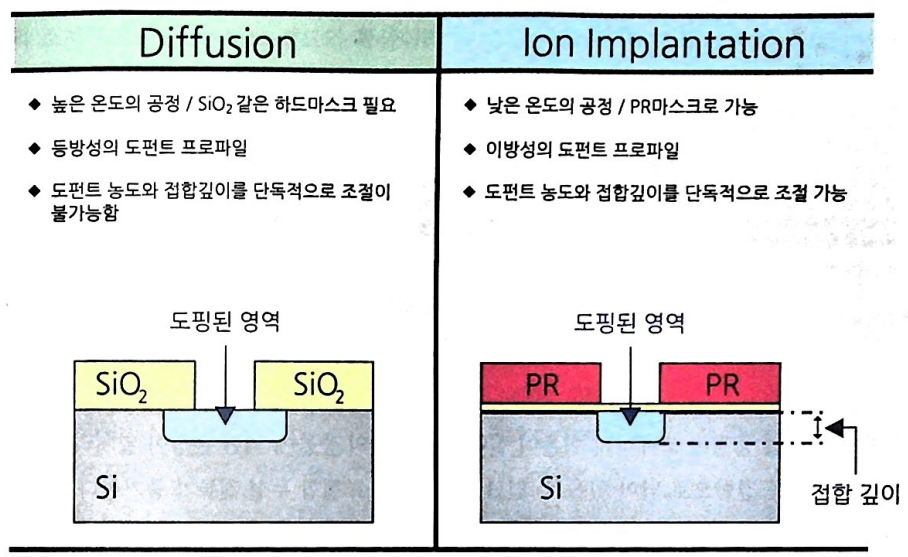
< 출처 : 렛유인 >
'etc. > 반도체 공정' 카테고리의 다른 글
| Aligner 이해 (3) 이슈 (0) | 2023.08.23 |
|---|---|
| Aligner 이해 (2) 작동 모드 (0) | 2023.08.21 |
| Aligner 이해 (1) 구조와 작동방식 (0) | 2023.08.17 |
| 증착공정(Deposition)에 대하여 (3) CVD (0) | 2023.08.09 |
| 증착공정(Deposition)에 대하여 (2) PVD (0) | 2023.08.08 |
