지난 글에서 산화공정은 웨이퍼를 외부의 불순물로부터 보호하고 누설전류를 막기 위해 절연층을 만드는 과정이고, 크게 습식 산화와 건식 산화가 있다고 말씀드렸는데요, 이번 글에서는 산화공정에 대해 자세히 알아보겠습니다.
- 산화막(Oxide)의 특징과 역할
먼저 oxide의 특징에 대해 알아볼까요?? 여기서 말하는 oxide는 SiO2입니다. 우선 웨이퍼의 원료가 Si이기 때문에 쉽게 형성할 수 있습니다. 또한 절연성과 Si과의 계면특성이 굉장히 좋아서 MOS 소자에서 Gate oxide로 사용할 수 있습니다. 또한, 도핑같은 확산 공정에서 필요한 부분만 노출시키는 양질의 Mask 역할을 합니다.
Si는 산화를 통해 SiO2로 만들면 부피가 늘어납니다. 치환비는 Si:SiO2 = 0.46:1로 거의 2배가 된다고 보시면 됩니다.
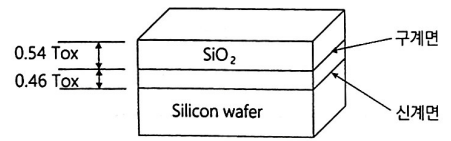
이 과정에서 Si 표면에 있던 불순물이나 결함이 산화막 내부에 포함되기 때문에 Si의 질이나 산화막과의 경계면이 안정해진다는 장점이 있습니다.

Si가 산화 시 부피가 늘어난다는 특징은 주변과 간섭을 막기 위한 고립공정(Isolation)에도 쓰였습니다. Si가 노출된 부분만 SiO2가 두꺼워지는데요, 이를 LOCOS(Local Oxidation of Silicon) 공정이라고 합니다. 이러면 경사가 완만한 부분이 생겨서 이후에 있는 공정이 쉬워지는 장점이 있는데요, 요즘에는 공정이 점점 미세화되어서 LOCOS 공정 대신 STI(Shallow Trench Isoation) 공정을 사용한다고 합니다.

산화의 부피팽창을 이용하는 것이 아니라, Nitride(질화물)를 사용해 선택적인 식각공정으로 Trench를 만들고 그 공간에 부도체인 oxide로 채우는 공정입니다.
- 산화방법
산화공정 방법에는 크게 건식산화(dry oxidation)와 습식산화(wet oxidation)가 있습니다. 이 둘의 차이는 말 그대로 물을 사용하느냐 사용하지 않느냐 차이인데, 이로 인해 산화속도와 산화막 질에 차이가 생깁니다.
1. 건식산화
Si는 공기중에 나둬도 1~2nm 정도의 native oxide가 생성됩니다. 하지만 반도체 공정에는 이보다 두껍고 질이 좋은 oxide를 필요로 하는데요, 그래서 고온(900~1200도)의 산소분위기에서 산화를 진행합니다.
Si(s) + O2(g) → SiO2(s)
2. 습식산화
습식산화는 수증기를 사용해 산화를 진행합니다.
Si(s) + H2O(g) → SiO2(s) + 2H2(g)
건식산화와 습식산화 모두 소스원자가 산화막을 지나 Si - SiO2 계면에서 Si와 반응하여 산화가 진행됩니다. 그런데 SiO2에서 H2O가 O2보다 용해도가 1,000배 정도 크기 때문에 H2O가 Si 계면에 빨리 다다르게 됩니다. 즉, 습식산화가 건식산화보다 산화속도가 월등히 빠릅니다. 다만, 습식산화가 속도가 빠르지만 밀도가 낮아 막의 질이 떨어진다는 단점이 있습니다.
'etc. > 반도체 공정' 카테고리의 다른 글
| 포토공정에 대하여 (3) 노광 (UV Exposure) - 1 노광 방법 (0) | 2023.07.25 |
|---|---|
| 포토공정에 대하여 (2) Photoresist (PR) (0) | 2023.07.05 |
| 포토공정에 대하여 (1) overview (0) | 2023.06.28 |
| 반도체 8대 공정 - 2 (0) | 2023.06.20 |
| 반도체 8대 공정 - 1 (0) | 2023.06.04 |
